今天小编要和大家分享的是晶圆简介,接下来我将从晶圆简介,这几个方面来介绍。
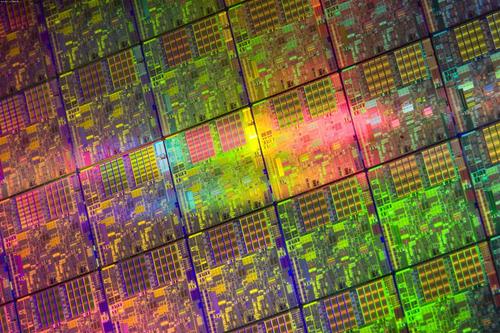
晶圆是指硅半导体积体电路制作所用之硅晶片,由于其形状为圆形,故称为晶圆;在硅晶片上可加工制作成各种电路元件结构,而成为有特定电性功能之ic产品。晶圆的原始材料是硅,很多文献上描述晶圆是矽制成,矽是硅元素的旧称。

晶圆简介
晶圆的原始材料是硅,地壳表面有着取之不尽用之不竭的二氧化硅,二氧化硅矿石经由电弧炉提炼,盐酸氯化,并经蒸馏后,制成了高纯度的多晶硅,其纯度高达0.99999999999。晶圆制造厂再将此多晶硅融解,再于融液内掺入一小粒的硅晶体晶种,然后将其慢慢拉出,以形成圆柱状的单晶硅晶棒,由于硅晶棒是由一颗小之部分结构:至於在某些半导体元件上常见的磊晶矽(epi)则是长在均匀的晶圆结晶表面上的一层纯矽结晶。多晶矽与磊晶矽两种薄膜的应用状况虽然不同,却都是在类似的制程反应室中经高温(600℃至1200℃)沉积而得。
即使快速高温制程(RapidThermalprocessing,RTp)之工作温度范围与多晶矽及磊晶矽制程有部分重叠,其本质差异却极大。RTp并不用来沉积薄膜,而是用来修正薄膜性质与制程结果。RTp将使晶圆历经极为短暂且精确控制高温处理过程,这个过程使晶圆温度在短短的10至20秒内可自室温升到1000℃。RTp通常用於回火制程(annealing),负责控制元件内掺质原子之均匀度。此外RTp也可用来矽化金属,及透过高温来产生含矽化之化合物与矽化钛等。最新的发展包括,使用快速高温制程设备在晶极重要的区域上,精确地沈积氧及氮薄膜。
离子植入技术:可将掺质以离子型态植入半导体元件的特定区域上,以获得精确的电子特性。这些离子必须先被加速至具有足够能量与速度,以穿透(植入)薄膜,到达预定的植入深度。离子植入制程可对植入区内的掺质浓度加以精密控制。基本上,此掺质浓度(剂量)系由离子束电流(离子束内之总离子数)与扫瞄率(晶圆通过离子束之次数)来控制,而离子植入之深度则由离子束能量之大小来决定。
化学机械研磨技术(ChemicalMechanicalpolishing,p):兼其有研磨性物质的机械式研磨与酸碱溶液的化学式研磨两种作用,可以使晶圆表面达到全面性的平坦化,以利后续薄膜沉积之进行。
在CMp制程的硬体设备中,研磨头被用来将晶圆压在研磨垫上并带动晶圆旋转,至於研磨垫则以相反的方向旋转。在进行研磨时,由研磨颗粒所构成的研浆会被置於晶圆与研磨垫间。影响CMp制程的变数包括有:研磨头所施的压力与晶圆的平坦度、晶圆与研磨垫的旋转速度、研浆与研磨颗粒的化学成份、温度、以及研磨垫的材质与磨损性等等。
制程监控:在下个制程阶段中,半导体商用CD-SEM来量测晶片内次微米电路之微距,以确保制程之正确性。一般而言,只有在微影图案(photolithographicpatterning)与后续之蚀刻制程执行后,才会进行微距的量测。
光罩检测:光罩是高精密度的石英平板,是用来制作晶圆上电子电路图像,以利积体电路的制作。光罩必须是完美无缺,才能呈现完整的电路图像,否则不完整的图像会被复制到晶圆上。光罩检测机台则是结合影像扫描技术与先进的影像处理技术,捕捉图像上的缺失。
当晶圆从一个制程往下个制程进行时,图案晶圆检测系统可用来检测出晶圆上是否有瑕疵包括有微尘粒子、断线、短路、以及其他各式各样的问题。此外,对已印有电路图案的图案晶圆成品而言,则需要进行深次微米范围之瑕疵检测。一般来说,图案晶圆检测系统系以白光或雷射光来照射晶圆表面。再由一或多组侦测器接收自晶圆表面绕射出来的光线,并将该影像交由高功能软体进行底层图案消除,以辨识并发现瑕疵。
切割:晶圆经过所有的制程处理及测试后,切割成壹颗颗的IC。举例来说:以0.2微米制程技术生产,每片八寸晶圆上可制作近六百颗以上的64RAM。
封装:制程处理的最后一道手续,通常还包含了打线的过程。以金线连接晶片与导线架的线路,再封装绝缘的塑胶或陶瓷外壳,并测试IC功能是否正常。
由於切割与封装所需技术层面比较不高,因此常成为一般业者用以介入半导体工业之切入点。
关于晶圆,电子元器件资料就介绍完了,您有什么想法可以联系小编。