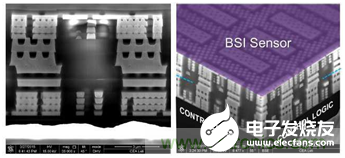
图15:混合键合封装的SEM图像(俯视图和3D视图),包括BSI成像器结构+逻辑的所有金属层。
为避开非键合区域,必须优化焊盘设计和表面抛光工序。套刻精度优于250nm的高性能对准系统能够实现最低7µm的高密度节距(图16)。
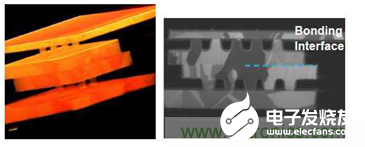
研究人员做了键合界面完整性表征实验,在附加的热应变实验后进行EDX分析,未在氧化层发现铜扩散现象(图17)。

图17:EDX混合键合界面表征,实验显示无铜通过界面扩散(在焊盘失准情况下)。
一份有关混合键合技术的电学表征实验和初步可靠性的研究报告证明,在300mm层叠晶片上,良率达到100%,在30k菊花链时,界面电阻离差较低。储热循环实验(图18)结果证明,技术成熟的图像传感器专用混合键合工艺实现了低电阻离差(小于0.5%)(ST内部数据待发布)。

图18:混合键合可靠性实验结果。热循环(左图)和储热(右图)测试的电阻离差小于0.5%。
直接键合的趋势:研究人员可能会想出更先进的解决方案,例如,3D VLSI CoolCubeTM集成,该方案利用独特的连接密度超过百万/平方毫米的通孔技术,可以垂直堆叠多层芯片,为异质集成带来新的机遇(高微缩化的像素、CMOS与NEMS混合架构、III-V/Ge材料)和设计灵活性,特别适合于线长微缩或神经形态计算(图19)。
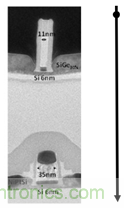
图19-CoolCubeTM原理
结论
硅3D集成现已成为现实,是一个高性能的半导体集成创新解决方案,可以替代因光刻技术投资庞大而在未来十年内难以维持经济效益的标准“摩尔定律”。3D集成被选择背后的动因是性能、带宽、复杂性、互连密度,以及系统微缩化、最终成本和价值链。热管理、热机械应变和连接密度等难题都已有相应的解决办法。随着直接混合键合套刻精度提高,业界可能会想出创新的集成方法,替代现有的裸片层叠解决方案,简化产品价值链,开发出功能分区、高密度互连的高性能器件。
责任编辑;zl